1. ArF 포토레지스트
반도체기술은 항상 미세화를 위해 개선되고 있습니다. 이전의 KrF(248nm) 포토레지스트에서 더 얇은 회로선폭, 고집적화를 이루기 위한 포토레지스트 파장의 변화는 ArF(193nm)로 옮겨갔습니다. 아래의 그림 처럼 패턴의 미세화를 위해서 "리소그래피 공정 파장"을 작게 하고 있습니다. Rayleigh 식에 따라서 패턴의 해상도는 공정파장에 비례하기 때문입니다.
ArF laser는 193nm의 파장을 가지는 빛입니다. 다른 파장의 포토레지스트와 마찬가지로 "ArF 포토레지스트"라고 해당 파장으로 부릅니다.
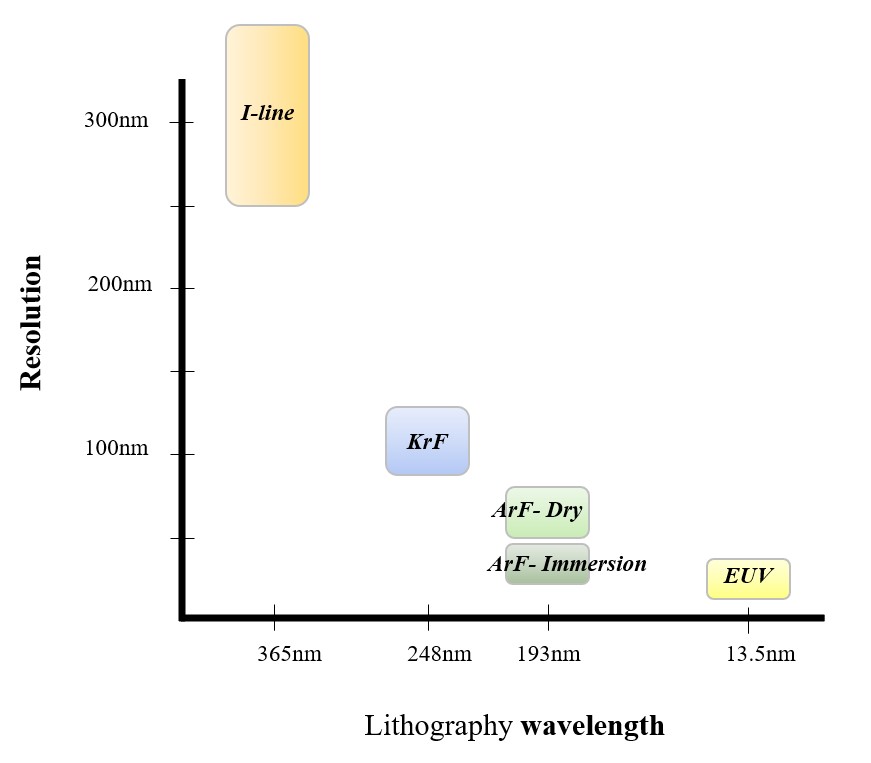
2. ArF 포토레지스트의 특징
포토레지스트는 리소그래피 공정 파장에서 흡광도가 낮아야 됩니다. 모든 포토레지스트 폴리머가 가져야 될 특징입니다. 포토레지스트가 흡광도가 있으면, 빛은 바닥까지 도달하기 어렵기 때문입니다.
아래 그래프는 포토레지스트 폴리머들의 흡광도를 파장에 따라서 분류한 그래프입니다. 193nm ArF 이전 기술은 248nm KrF 레지스트입니다. KrF에서 사용하던 폴리머를 ArF에서도 사용하면 되지 않을까요? 안됩니다. KrF 레지스트는 polyhydroxy styrene구조의 폴리머입니다. 폴리머 구조에 있는 benzene그룹은 193nm 부근에서 강한 흡광을 가지게 되어 사용할 수 없습니다. 따라서 193nm에서는 새로운 폴리머가 필요하게 됐고, 바로 Polyacrylate가 적용되었습니다.
polyacrylate는 Ohnish parameter가 굉장히 낮은 구조입니다. polymer 자체가 etch에 대해서 저항성이 낮은 aliphatic 구조인데, etch 저항성을 높이려면 ring sturcture가 필요하게됩니다. ArF 포토레지스트에서 빛의 투과도와 etch 저항성은 시소와 같은 trade-off 물성입니다.
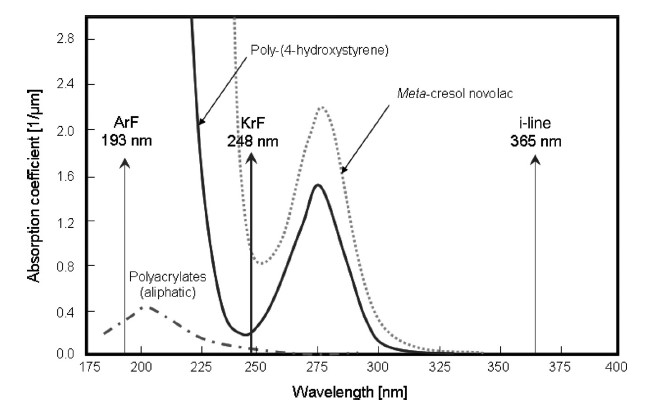
3. ArF 포토레지스트의 구조와 반응 특징
1)포토레지스트 폴리머의 구조
193nm ArF포토레지스트 폴리머는 아크릴계열 폴리머가 많이 사용됩니다. KrF레지스트 폴리머와 비교하시면 phenyl기의 유무에서 차이가 있다는 점을 알 수 있습니다.
아크릴 수지는 에치저항성이 낮아, R1-R2-R3 위치에 결합하는 보호기에 따라 etch 저항성이 달라집니다. 마찬가지로 Litho performance도 변하게 됩니다.
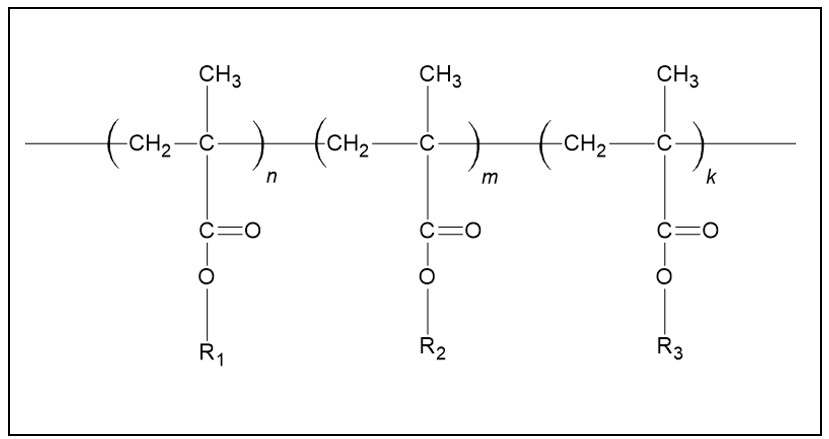
목표하는 물성에 따라서 고분자 조성은 여러 가지의 조합을 갖습니다. 일반적으로 leaving 그룹(R1)과 polar 그룹(R2), Lactone 그룹(R3)으로 나눕니다.
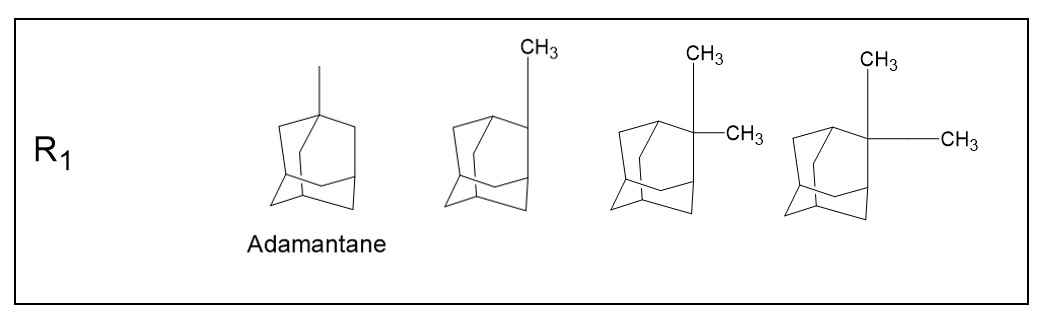


2) ArF 포토레지스트 구성성분
ArF 포토레지스트 역시 화학증폭형 레지스트입니다. 구성성분은 KrF 레지스트와 거의 동일합니다. (1) Acrylic polymer, (2) PAG, (3) Base, (4) Solvent 크게 네 가지의 구성성분을 갖고 있습니다.
polymer는 패턴을 형성하는 역할을 합니다. 리소그래피 공정 파장에서 투과도가 좋고 etch 저항성도 높은 타입입니다. PAG은 산을 만들어줍니다. Base는 비노광부로 산이 확산되는 것을 억제해 주는 CAR 시스템의 컨트롤러입니다. Solvent는 모든 물질을 균일하게 녹여주는 carrier material입니다.

'Technology > Semiconductors' 카테고리의 다른 글
| [Novolac/DNQ]용해도 변화 원리 (0) | 2023.04.05 |
|---|---|
| [PAG]Photo Acid Generator 깔끔하게 이해하기 (1) | 2023.03.27 |
| PAC과 PAG 무엇이 다를까? (0) | 2023.01.24 |
| 화학증폭형 포토레지스트의 원리(Chemically amplified resist, CAR system) (4) | 2023.01.20 |
| KrF 포토레지스트의 개념과 반응(positeve) (6) | 2023.01.12 |



