1. PAC(Photo Acid Compound)
1) 정의
I-line 포토레지스트 Novolac/DNQ system에 사용되는 dissolution inhibitor입니다. Novolac 수지에 첨가된 경우 THAM에 대한 용해도를 낮게 만드는 특징이 있습니다. 노광 후에는 DNQ가 Acid로 구조가 변하면서 포토레지스트의 "용해도"를 컨트롤할 수 있게 해주는 역할을 합니다.
① Novolac → 현상액에 용해도 (중간)
② Novolac + PAC→ 현상액에 용해도 (매우 낮음)
③ Novolac + PAC + Light → 현상액에 용해도 (매우 높음)
※PAC : Diazonaphthoquinone(DNQ)
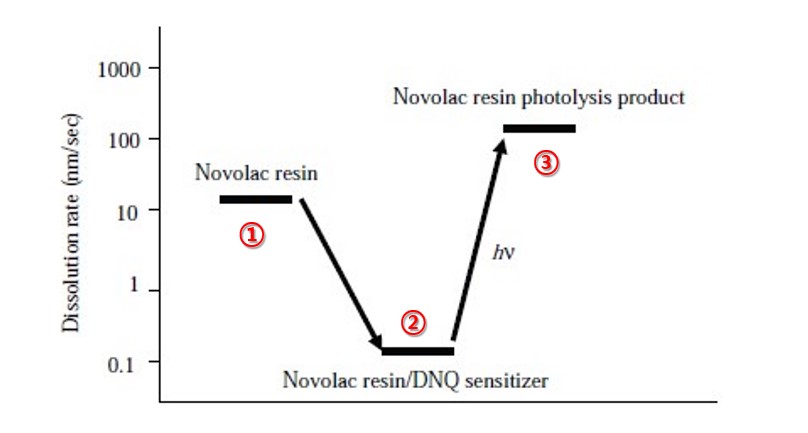
2) 사용용도
G-line(436nm) 또는 I-line(365nm) 파장에서 포지티브 레지스트용도로 사용됩니다. 포토레지스트의 노광 시 폴리머에는 반응이 없는 특징이 있습니다. 빛을 흡수한 PAC만 구조가 변경되며 용해도가 바뀝니다. 패턴 생성의 sensitivity는 Polymer/PAC 비율에 큰 영향을 받습니다.
2. PAG(Photo Acid Generator)
1) 정의
KrF(248nm), ArF(193nm) 포토레지스트에 사용되는 산을 생성하는 소스입니다. 빛을 받으면 proton(H+)를 방출하며 포토레지스트 폴리머의 반응 촉매가 됩니다.
① Polymer + PAC → 현상액에 용해도 (낮음)
② Polymer + PAC + Light → 현상액에 용해도 (높음)
2) 사용용도
KrF, ArF 파장의 포토레지스트의 반응 촉매로 사용됩니다. 빛을 받으면 PAG자체에서도 구조가 변하면서 proton이 생성되며, 폴리머에도 반응이 일어나게 만들어줍니다. KrF이하의 파장에서는 폴리머에 결합된 protecting group의 갯수에 따라서 용해도가 변하기 때문입니다. 패턴 생성의 sensitivity는 quencher에 영향을 많이 받습니다. PAG을 deactiviation 시킬 수 있는 물질이기 때문입니다.
3. 요약
| 구분 | PAC(Photo acid compound) | PAG(Photo acid generator) |
| 역할 | Dissolution inhibitor | Proton generator |
| 사용용도 | G-line / I-line 포토레지스트 수지에서 Novolac수지의 용해도를 조절 |
KrF, ArF 포토레지스트 수지에서 Protecting group의 이탈반응 촉매 |
| 메커니즘 | Diazonaphthoquinone(DNQ)가 노광 시 Acid로 변함 | 노광시 Proton을 생성시키며, 고분자에 있는 protection 그룹을 이탈시킴 |
| 포토레지스트 배합 | Polymer(Novolac) PAC Solvent |
Polymer(t-BOC, ENCAP etc) PAG Quencher Solvent |
| 특징 | Polymer는 반응하지 않음 PAC은 구조가 변함(DNQ→ Acid) |
Polymer는 반응 함 PAG은 구조가 변함(proton 생성) |
| 패턴 Sensitivity에 영향을 주는 인자 | Polymer or DNQ의 양 | Quencher의 양 |
https://2zyo1011.tistory.com/37
[PAG]Photo Acid Generator 깔끔하 이해하기
1. Photo Acid Generator(PAG) PAG는 리소그래피공정의 포토레지스트에 들어가는 산(H+) 발생제입니다. 248nm KrF, 193nm ArF 공정에 주로 들어갑니다. 해당 공정에서는 화학증폭형레지스트(Chemically Amplified Resis
2zyo1011.tistory.com
PAC(팩)과 PAG(패그)는 비슷한 개념으로 오해하기 쉽습니다. 각각의 파장에서 PAC과 PAG가 어떤 메커니즘으로 반응하는지 궁금하시면 이전 포스팅을 참고 바랍니다.
'Technology > Semiconductors' 카테고리의 다른 글
| [PAG]Photo Acid Generator 깔끔하게 이해하기 (1) | 2023.03.27 |
|---|---|
| ArF(Dry) 포토레지스트 개념과 구조(Positive) (0) | 2023.02.04 |
| 화학증폭형 포토레지스트의 원리(Chemically amplified resist, CAR system) (3) | 2023.01.20 |
| KrF 포토레지스트의 개념과 반응(positeve) (4) | 2023.01.12 |
| I-line 포토레지스트의 성분 및 반응(Negative) (0) | 2023.01.08 |



