KrF 포토레지스트의 개념과 반응(positeve)
KrF 포토레지스트
1990년대 포토레지스트의 미세화 기술은 I-line의 한계를 넘어가고 있었습니다. I-line 포토레지스트가 구현할 수 있는 최소의 회로 선폭보다 얇은 회로가 필요했습니다. 따라서 리소그래피 기술은 공정 파장을 옮기는 방향으로 기술이 변했습니다.
"I-line(365nm) → KrF(248nm)"
KrF laser는 248nm의 파장을 가지는 빛입니다. KrF 파장에서 사용하는 포토레지스트를 "KrF 포토레지스트" 또는 "DUV 포토레지스트"라고 일반적으로 부릅니다. 리소그래피 공정의 파장이 바뀌면서, 포토레지스트 소재개발도 역시 필요했습니다. 기존 I-line에서 사용하던 노볼락 수지는 248nm에서 흡광도가 높아 사용할 수 없었기 때문입니다.
포토레지스트의 성분의 중요한 특징
1. 폴리머 : 리소그래피 공정 파장에서 흡광도가 낮아야 된다.
2. PAC/PAG : 리소그래피 공정 파장에서 높은 흡광도를 가져야 된다.
KrF 포토레지스트의 개발
수많은 과학자들이 248nm 공정에 맞는 소재 개발을 위해 노력했습니다. 패턴형성이 잘 되고, 포토레지스트 저장에도 용이하고, etch resistance도 높고, 리소 공정에서 흡광도가 낮고 등등.... 여러 가지 물질이 후보군에 올랐지만 지금까지 가장 널리 사용되는 포토레지스트 폴리머는 Polyhydroxystyrene(PHOST)가 되었습니다.
※KrF포토레지스트에는 여러가지가 들어가지만, 포토레지스트의 폴리머에 대해서 아는 것이 먼저 필요합니다.
PHOST는 어떤 메커니즘으로 DUV파장의 포토레지스트 폴리머가 되었을까요?

PHOST는 Hydroxy styrene의 free radical polymerizaion으로 제조할 수 있습니다. Hydroxy styrene을 단독으로 사용한 경우 아래와 같은 homopolymer가 얻어집니다.

PHOST는 말단에있는 -OH그룹의 영향으로 염기성 현상액(developer)에 잘 씻겨나갑니다. 만약 -OH그룹을 가려놨다가, 필요할 때만 보이게 한다면 어떨까요?
KrF 포토레지스트의 핵심은 PHOST의 -OH그룹의 수를 조절하는 것입니다. 노광 전에는 PHOST에서 OH그룹이 안 보이게 가려놨다가, 노광 후에는 OH그룹이 보이게 하는 기술입니다. 실제로 구현할 수 있는 컨셉은 여러 가지지만 대표적인 세 가지는 아래와 같습니다.
1. KrF 포토레지스트 폴리머의 종류
(1-1) tert-butoxycarbonyl groups(t-BOC) 보호된 PHOST
Hydroxy styrene구조의 -OH 그룹에 tert-butuxoycarbonyl기가 보호기로 붙어있는 것을 일반적으로 t-BOC라고 부릅니다. -OH그룹이 가려져 있어 현상액에 대해 용해도가 상대적으로 낮은 구조입니다.


t-BOC을 hydroxy styrene과 co-polymer로 만들게 되면 위와 같은 구조의 고분자를 얻을 수 있습니다. t-BOC이 있는 co-polymer는 PHOST보다 당연히 현상액에 대해서 용해도가 낮습니다. 하지만 노광 후 t-BOC 보호기가 떨어져 나가면, 현상액에 대한 용해도가 PHOST와 같아집니다.

노광된 부분이 용해도가 증가 → 현상공정에서 씻겨나감 → 노광 되지 않은 부분이 패턴으로 남게 됨. 전형적인 포지티브(Positive) 포토레지스트의 메커니즘입니다.
(1-2) Ester 보호된 PHOST (ENCAP)
환경적으로 안정된 화학증폭형 포토레지스트Environmentally stable chemically amplified photoresist(ENCAP)는 tert-butyl acrylate와 hydroxy styrene의 co-polymer로 만들 수 있습니다. ENCAP이라고 부르는, tert-butyla acrylate의 낮은 Tg로 전체 copolymer의 Tg가 낮아지게 되고, PEB 단계에서 레지스트 매트릭스의 void를 채워 system에서 기인하는 오염을 방지할 수 있기 때문입니다.


ENCAP 역시 노광 후 보호기가 떨어져 나가면서 현상액에 대한 용해도가 변합니다. tert-butyl acrylate의 tert-butyl 그룹이 보호기로 작용하다가, 노광 후 proton에 의해 떨어져 나갑니다.
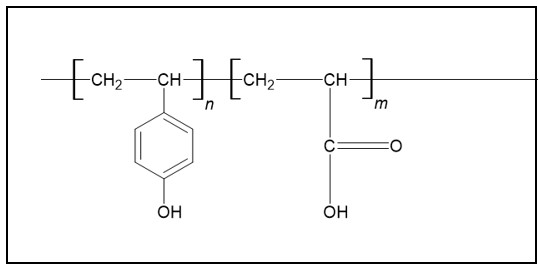
(1-3) ACETAL 보호된 PHOST
Acetal 보호된 PHOST도 t-BOC, ENCAP과 동일한 메커니즘으로 포지티브 패턴을 형성합니다. 그러나 한 가지의 차이점은, ACETAL은 노광 후 proton이 생면 보호기 이탈이 바로 일어납니다. PEB전에도 보호기 이탈이 일어나기 때문에 노광 후 PEB를 하기까지 걸리는 시간도 패턴의 두께에 영향을 주게 됩니다.

Acetal 구조의 모노머는 methoxypropyloxystyrene을 사용합니다. Hydroxy styrene과 methoxypropyloxystyrene을 일정비율로 아래와 같은 copolymer를 만들 수 있습니다.

노광 후 생성된 proton이 methoxy 기를 공격하여 보호기가 떨어지게 됩니다. 기존 두 가지와의 차이점은 노광 후 생성된 proton이 바로 보호기를 이탈 시긴다는 점입니다.

지금까지 설명드린 모든 구조에서 보호기는 Proton과 열이 있으면 떨어져 나갑니다. 그렇다면 proton은 어디서 나오는 걸까요?
2. 화학증폭형 포토레지스트(Chemically amplified resist, CAR system)
KrF/ArF 포토레지스트는 '화학증폭형 포토레지스트'라고 부릅니다. 화학적으로 무언가가 증폭된 포토레지스트입니다. 무엇이 증폭되었을까요? 바로 노광 된 부분에서 Proton이 생성되고 diffusion 되는 것입니다.
지금까지 KrF 포토레지스트는 폴리머의 세 가지 종류를 알아봤습니다. ①t-BOC, ②ENCAP, ③ACETAL 모두 side chain에 -OH수의 따라 현상액에 대한 용해도가 달라집니다. -OH그룹의 수를 조절하기 위해, 노광 전에는 -OH그룹이 각각의 보호기로 protecting 된 상태입니다. 노광이 되면 어딘가에서 생긴 Proton이 protecting 그룹을 공격하며 떨어져 나갑니다.
Proton 생성을 위해 포토레지스트에 넣어주는 물질이 Photo Acid Generator(PAG)입니다. I-line에서도 비슷한 게 있었습니다. Photo active compound(PAC)입니다. PAC은 빛을 받으면 구조가 변하면서 레지스트의 용해도를 조절했다면, PAG은 빛을 받으면 Proton을 생성합니다. I-line과 KrF 이하의 레지스트는 메커니즘이 다르기 때문입니다.
PAG은 proton을 생성하며 보호기를 떨어트리는 촉매의 역할을 합니다. 그런데 보호기가 떨어지고 나서 또다시 proton이 생깁니다. Proton은 없어지지 않고 계속해서 diffusion 됩니다. '화학증폭형 포토레지스트'라고 부르는 이유입니다.
노광 후 Proton 생성 → 보호기 이탈(PEB) → Proton 생성&Diffusion
화학증폭형 포토레지스트는 빛을 받으면 Proton이 생기고 끊임없이 diffusion 됩니다. 화학적으로 증폭되어 가속을 한다면 브레이크도 필요하겠죠? 브레이크역할을 하는 것이 Quencher(or Base)입니다. Quencher는 염기성 화학물로 노광 된 부분에서 비노광 부분으로 diffusion 되는 산을 중화시켜 줍니다. Quencher가 없으면, 산은 노광 되지 않은 부분까지 diffusion 되어서 해상도나 마진을 낮출 수 있습니다. Quencher에 대해서는 다음 포스팅에서 정리하겠습니다.
3. KrF 포토레지스트의 구성성분
결론적으로 KrF 포토레지스트에 꼭 필요한 것은 ①Polymer, ②PAG, ③BASE 그리고 ④Solvent입니다. 폴리머는 Hydroxy styrene을 기반으로 한 여러 가지 co-polyer가 사용됩니다.

4. KrF 포토레지스트의 메커니즘
(4-1) 노광
노광이 되면 제일 먼저 PAG이 분해됩니다. DUV에서의 PAG은 Proton을 생성합니다. PHOST에 protecting 된 구조에 따라서 보호기의 이탈이 달라집니다.
t-BOC/ ENCAP : 노광 후 PEB에서 보호기 이탈
ACETAL : 노광직후 보호기 이탈
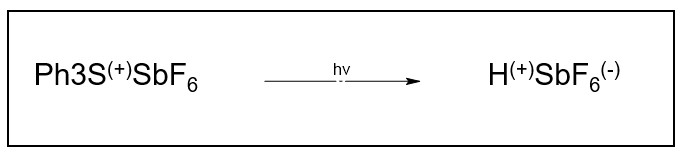
4-2) PEB 및 보호기의 이탈
Post Exposure Bake(PEB) 과정에서 Proton이 보호기를 공격하며 폴리머 chain을 보호기가 없는 hydrophilic구조로 변환시켜 줍니다.
(A) t-BOC
t-BOC protecting 된 PHOST는 proton과 heat 존재하에서 CO2와 tert butyl cation을 형성합니다. 전자의 이동은 아래 그림을 참고 바랍니다. 그림에서 붉은색 proton은 초기 PAG에서 생성된 것입니다. 이 proton은 폴리머의 main chain의 oxygen의 공격을 받아 -OH를 형성합니다. 생성된 tert butyl cation은 proton을 방출하며 isobutylene을 형성합니다. Proton은 소모되지 않으며, 노광 된 부분에서 반응을 하며 diffusion 합니다. 화학증폭형 포토레지스트의 핵심 메커니즘입니다.
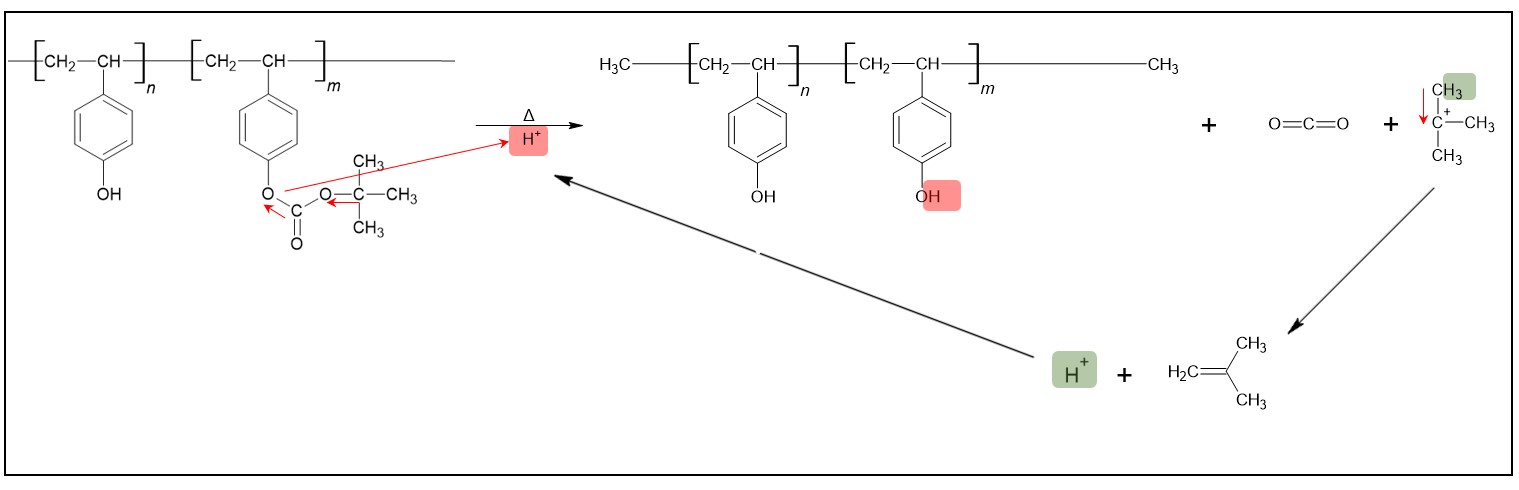
(B) ENCAP
PAG에서 생성된 proton은 tert butyl cation을 형성하고, isobutylene을 형성하는 메커니즘이 동일합니다.
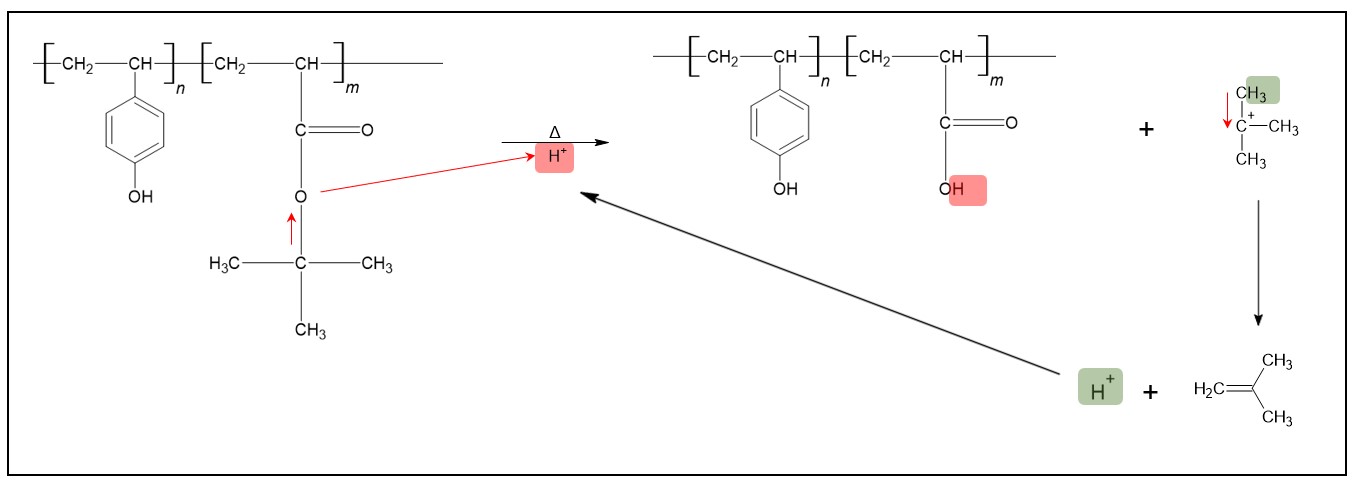
(C) ACETAL
ACETAL의 탈보호 메커니즘도 대부분 유사하지만, t-BOC이나 ENCAP보다 더 낮은 온도에서 보호기가 이탈합니다. 따라서 노광 직후부터 탈보호가 진행되어 PEB공정을 완료하는 데 까지 걸리는 시간이, 패턴의 CD에 영향을 줄 수 있습니다.
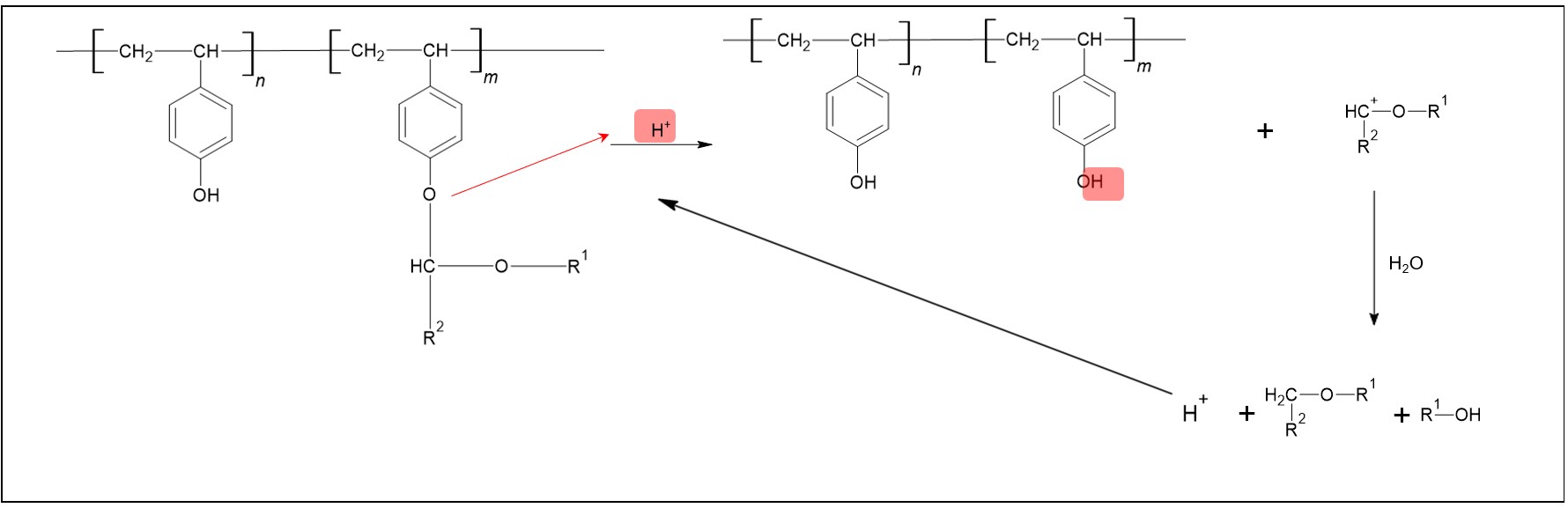
미세화된 패턴을 구현하기 위해 리소그래피 파장이 점점 짧아졌습니다. i-line에서 KrF 파장으로 짧아지며 새로운 레지스트 소재도 필요했습니다. 반도체 산업에서는 PHOST를 레지스트 폴리머로 적용했습니다. 노광 전에는 t-BOC, ester, ACETAL로 protectin 시켜 용해도를 낮춰놓다가, 노광 및 PEB를 하면 보호기가 이탈되도록 설계했습니다. 또 다른 핵심적인 내용은 "화학증폭형 메커니즘"입니다. 노광에서 생성된 Proton은 없어지지 않고, 계속해서 촉매로 사용되면서 diffusion 됩니다.