I-line 포토레지스트의 개념,성분 그리고 반응(Positive)
I-line 포토레지스트 개요
리소그래피(Lithography) 공정에서 파장에 따라 포토레지스트를 분류할 수 있습니다. 수은램프 365nm 파장의 빛은 I-line이라고 하며 이때 사용하는 포토레지스트를 "I-line 포토레지스트"라고 일반적으로 부릅니다.

반도체기술은 패턴의 미세화에 초점이 맞춰져 있습니다. 웨이퍼에 패턴을 얼마나 작게 그리느냐에 따라서 성능과 수율이 모두 달라지기 때문이죠. Rayleigh의 식에 따라서, 회로선폭(CD)은 리소그래피에 사용하는 파장(λ)에 비례합니다. 짧은 파장을 사용할수록, 회로선폭을 더 얇게 그릴 수 있습니다.

최근 많이 사용되고, 기술난이도가 높은 광원은 ArF를 이용한 포토레지스트입니다. EUV는 말할 것도 없죠. I-line 포토레지스트는 오래되었지만, 1990년대 64Mb DRAM 생산을 가능케 한 소재입니다. 게다가 현재까지도 지속적인 공정/소재 개발로 사용하고 있는 만큼 의미 있는 소재입니다.
I-line 포토레지스트의 특징
I-line 포토레지스트 역시 포지티브(Positive)와 네거티브(Negative)로 나눌 수 있습니다.
I-line 포지티브는 노광된 부분에서 용해도 변화가 생깁니다. 빛을 받기 전, 레지스트는 현상액에 용해도가 낮습니다. 그런데 빛을 받는 순간, 내부의 화학적 변화로 그 부분만 현상액에 용해도가 높아집니다. 따라서 노광 된 부분은 현상액에 씻겨나가고, 노광 되지 않은 부분만 패턴으로 남아있습니다.
I-line 네거티브, 그 중에서도 acid catalyzed system, 빛을 받은 부분에서 폴리머의 가교결합이 일어납니다. 가교구조가 되면 현상액에 용해되지 않습니다. 결론적으로 현상액에 녹는 부분은 '노광 되지 않은 부분'이 되고, 노광 된 부분은 패턴으로 남습니다.

포지티브(Positive) : 노광된 부분이 현상액(developer)에 용해됩니다. 빛에 노광 되지 않은 부분이 substrate 위에 잔류합니다.
네거티브(Negative) : 노광된 부분이 현상액에 용해되지 않습니다. Substrate위에는 crosslinkin된 폴리머 구조가 패턴으로 남습니다.
포지/네가가 다르게 작동하는 원리는 무엇일까요? 포토레지스트의 성분과 그것들의 chemistry를 통해 설명드리겠습니다.
■ I-line positive resist
1) Positive resist 구성성분
I-line 포토레지스트의 구성성분은 ①Solvent, ②PAC(Photho active compound), ③Polymer(Novolac) 크게 세 가지입니다. Solvent는 ether계열을 많이 사용하고, PAC으로는 Diazonaphthoquinone(DNQ)을 사용합니다. I-line 포토레지스트의 반응에서는 DNQ가 제일 중요합니다. 마지막으로 폴리머는 노볼락(Novolac)을 사용합니다.
※포토레지스트에 사용하는 노볼락은 Cresol과 포름알데히드를 반응시킨 폴리머입니다. 노볼락수지의 합성/중합에 대해서 궁금하시면 . 페놀수지(노볼락) 반응 에 대한 이전 포스팅을 확인해주세요.


2) Chemistry of I-line positive resist
포토레지스트의 메커니즘을 설명드리기 전에 리소그래피 공정을 간단히 리뷰해보겠습니다. 리소그래피 공정은 웨이퍼에 포토레지스트를 코팅하고, 노광 그리고 현상하는 공정으로 간단히 말할 수 있습니다. 현상 공정은 현상액(TMAH solution)으로 노광 된 레지스트를 씻어주는 공정입니다.
| 코팅 | 노광 | 현상 |
| 웨이퍼 위에 레지스트를 코팅 | 레지스트에 빛을 조사 | 레지스트를 현상액으로 현상 |
포토레지스트의 핵심은 여기에 있습니다. 포토레지스트 성분 중에 Novolac과 DNQ 그리고 현상공정의 현상액 TMAH 2.38% solution의 조건에 따른 용해도 차이입니다.
아래 그래프에서,
①: 노볼락이 단독으로 있을 때 입니다.
②: 노볼락에 DNQ를 혼합한 상태입니다. 현상액에 대한 용해도가 1/10 이하가 되며 현상액에 잘 녹지 않게 됩니다.
③: 365nm의 빛을 받은 뒤에 DNQ의 반응으로 현상액에 대한 용해도가 1000배 정도 증가합니다.
여기서 ② 구간과 ③구간의 용해도 차이는 1000배 정도입니다. 노볼락과 DNQ를 혼합하여 용해도를 조절하기 때문에, DNQ를 Dissolution inhibitor라고 지칭합니다. 노볼락에 DNQ가 얼마나 들어갔는지, 그리고 DNQ가 노광 됐는지에 따라서 포토레지스트의 현상액에 대한 용해도가 달라지기 때문입니다.
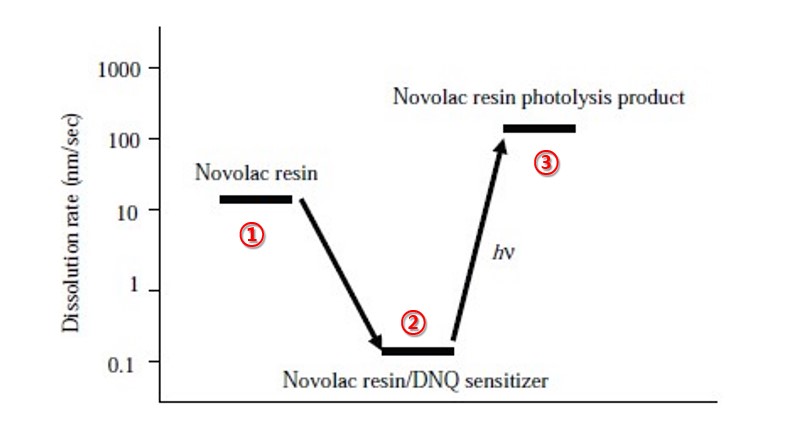
“The resist technique A chemical contribution to electronics,”Angew. Chem. Int. Ed. (English) 21, 455 (1982).

DNQ는 I-line(365nm) 파장의 흡수율이 좋은 물질입니다. 빛을 받기 전에는 non-polar sturcture로 hydrophobic 합니다. 빛을 받으면 N2의 제거와 동시에 carbene을 형성합니다. carbene은 Wolf재배열을 통해 ketene을 형성하고, 최종적으로 Indene carboxlic acid가 됩니다. 초기 hydrophobic 구조에서 최종적으로는 hydrophilic 구조가 되었습니다. 따라서 빛을 받은 부분은 DNQ가 친수성인 Indece carboxylic acid가 되고, 친수성 현상액인 TMAH에 잘 녹는 구조가 됩니다.

노볼락수지와 PAC(DNQ)의 변화를 노광부/비노광부로 나눠서 표현했습니다. 노광 된 부분은 DNQ가 Indene carboxylic acid가 되었고, 노광 되지 않은 부분은 DNQ로 남아있습니다. 두 조성의 TMAH에 대한 1000배 정도 용해도 차이가 현상공정에서 나옵니다.
I-line 포지티브 레지스트는 DNQ의 분자구조 변화에 따른 레지스트의 용해도 변화가 핵심인 포토레지스트입니다. 다음에는 I-line negative photoresist의 chemisty와 I-line 레지스트의 한계에 대해서 포스팅하겠습니다.